
TECHNOLOGY
半導体検査ソリューション
サキは半導体パッケージ工程の自動外観検査装置・X線検査装置を開発しています。
マイクロバンプやTSV(TGV)などの不良を高精度に検出。微細化・複雑化する半導体製造現場の課題を解決し、AI・5G・EV時代に求められる品質保証を支えます。
半導体パッケージの検査対象
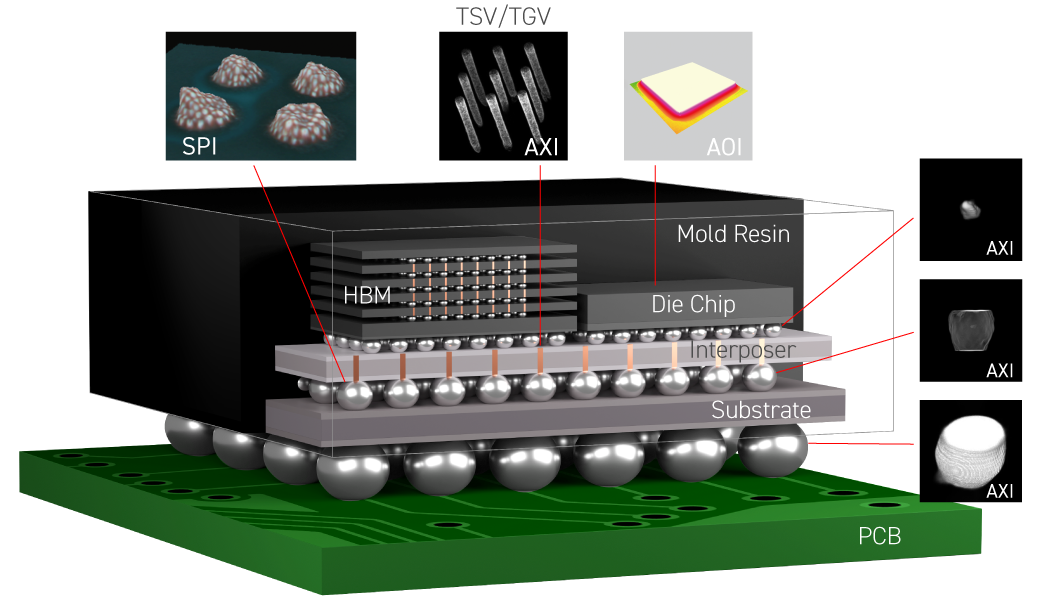
01
マイクロバンプの3D検査
サキの高解像度3μm SPIは印刷厚みの薄いマイクロバンプの自動検査が可能です。
自動外観検査でありながら3D測定器レベルの正確さで、マイクロバンプの計測ができます。
50μm以下のステンシルに対するはんだ印刷検査にも対応しています。
02
ダイチップ表面の高さ測定
03
マイクロバンプ、C4バンプ、BGAバンプを同時にX線検査
高解像度X線検査
サキの高解像度AXIは、半導体内部はんだ接合部のX線自動検査が可能です。
半導体チップとインターポーザ間のマイクロバンプを検査するため、プラナーCTを構成するステージの剛性、精度、精密な装置キャリブレーションによって、断層画像の高解像度化と深い被写界深度を実現しました。
“One Scan, Multi-Layer Inspection”
サキAXIの特長は、多層構造を持つ半導体パッケージでも1回の撮像で各はんだ層を正確に分離し、同時検査ができることです。
一般的なAXIは多層構造の対象物を検査する際、1はんだ層ごとに撮像を行う必要があります。サキは1回の撮像で複数層の画像取得が可能なため、チップ内の全てのはんだ接合レイヤーを一度のPCT撮像で検査できます。撮像時間の短縮により、X線被ばく線量を抑えることができます。
半導体パッケージの多層構造
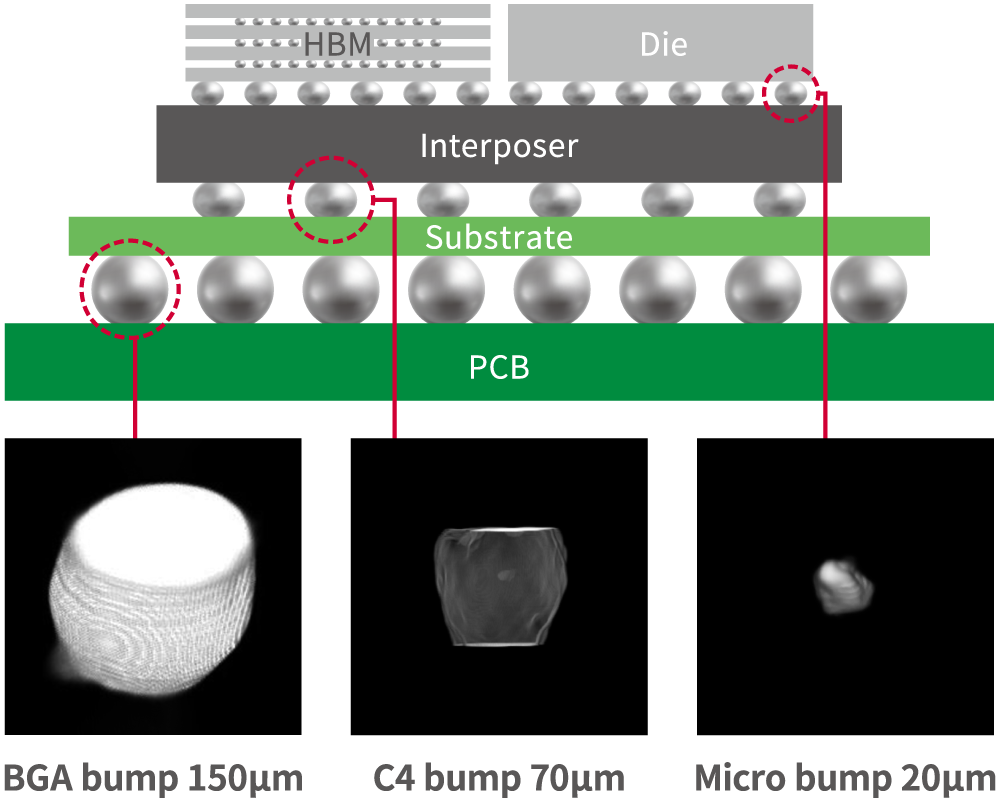
サキの3次元CT検査(トモグラフィ)は高精細画像の取得を得意とし、マイクロバンプ(20μm)のブリッジ検査、C4バンプ(70μm)、BGAバンプ(150μm)の不濡れ、ボイド検査など、難易度の高い検査に対応できます。
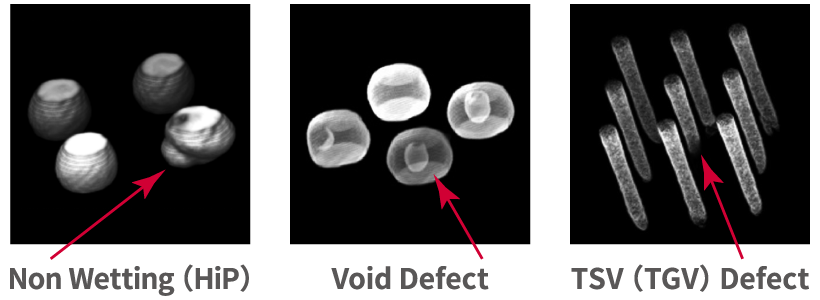
インライン化を実現する高速検査
SMT工程のX線検査にも使用されるサキのAXIはインライン化で求められるサイクルタイムを満たします。
サキのAXIは独自の高速演算処理により、撮像と演算処理がほぼ同時に行われるため、リアルタイムで3Dデータの取得・検査が可能です。
被ばくによる部品故障のリスクを低減
サキのX線検査装置は被ばく線量シミュレーターを搭載しているため、部分ごとの被ばく線量を予測して撮像条件を最適化できます。また、撮像時のみX線を照射しており、照射量を最小限に抑えています。
被ばく線シミュレーター

サキは半導体検査ソリューション開発の手を止めません。今後はウェーハレベルの検査技術も確立し、半導体製造の全ての品質保証を担っていきます。
関連ソリューション
3D-SPI
3D はんだ印刷自動検査装置

3D-AOI
3D 自動外観検査装置

3D-CT AXI
3D-CT X線自動検査装置


